신소재 ‘High-K EMC’ 적용…열전도도 3.5배, 열 저항 47% 개선
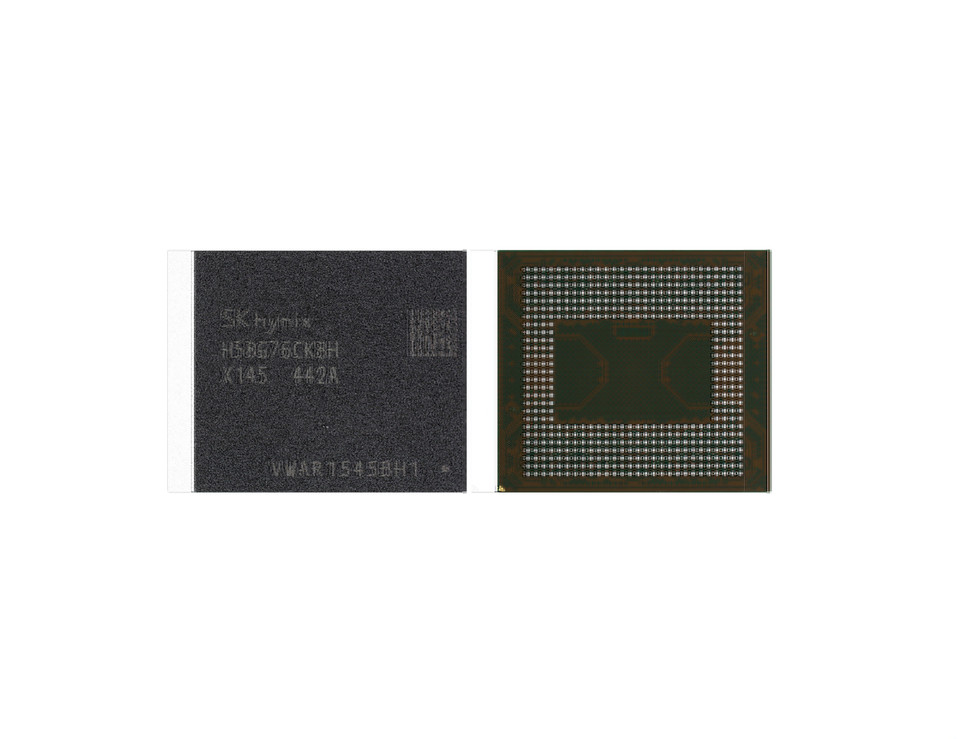
SK하이닉스가 발열 문제에 대한 새로운 해법을 제시하며 차세대 모바일 D램 시장 공략에 본격 나섰다.
SK하이닉스는 28일 업계 최초로 신소재 ‘High-K EMC’를 적용한 고방열 모바일 D램 제품의 공급을 시작했다고 밝혔다. 이 제품은 온디바이스 AI(On-Device AI) 구현 등으로 데이터 고속처리가 늘어나면서 생기는 발열 문제를 혁신적으로 개선해 글로벌 고객사들로부터 높은 평가를 받고 있다.
이번에 적용된 High-K EMC는 반도체 패키지를 감싸는 후공정 핵심소재인 EMC(Epoxy Molding Compound)에 열전도율(K)이 높은 알루미나(Alumina)를 기존 실리카(Silica)와 혼합해 적용한 것이 핵심이다. 그 결과 기존 대비 열전도도가 3.5배 향상됐고, 열이 수직으로 이동하는 경로의 열 저항도 47% 개선되는 성과를 거뒀다.
EMC는 반도체를 외부 환경으로부터 보호하는 동시에 내부에서 발생한 열을 외부로 배출하는 역할을 한다. SK하이닉스는 이 소재 혁신을 통해, 좁은 공간에서 고성능 칩을 사용하는 최신 스마트폰 환경에서 발열 문제를 실질적으로 해결할 수 있게 됐다고 설명했다.
최근 플래그십 스마트폰은 모바일 애플리케이션 프로세서(AP) 위에 D램을 쌓는 PoP(Package on Package) 구조가 보편화되고 있다. 이 방식은 공간 활용과 데이터 처리 속도에는 유리하지만, AP에서 발생한 열이 위쪽 D램까지 영향을 주면서 전체 기기의 성능 저하를 유발하는 문제가 있었다.
SK하이닉스는 이 같은 구조적 한계를 타개하기 위해 D램 자체의 방열 성능을 개선하는 데 주력했고, 그 결과 스마트폰의 성능 안정성, 소비전력 절감, 배터리 수명 연장 등 다양한 부가효과까지 확보하게 됐다.
이규제 SK하이닉스 부사장(PKG제품개발 담당)은 “이번 제품은 단순한 반도체 성능 향상이 아니라, 사용자가 체감하는 불편을 실질적으로 줄인 데 의미가 있다”며 “소재 기술 혁신을 기반으로 차세대 모바일 D램 시장의 기술 리더십을 공고히 하겠다”고 말했다.
업계에서는 고방열 모바일 D램이 AI 연산량이 증가하는 모바일 디바이스 환경에서 스마트폰 제조사의 경쟁력을 좌우하는 핵심 부품으로 부상할 것으로 보고 있다. SK하이닉스는 이번 제품을 통해 차세대 모바일 기기의 성능과 사용성을 모두 끌어올리는 '엔진 역할'을 하게 될 것으로 기대하고 있다. /김재옥기자

